| [1] |
孙鹏跃, 刘旭辉, 毛二坤, 等. 利用分时刷新和位置约束的卫星载荷BRAM抗辐照设计方法[J]. 国防科技大学学报, 2023, 45(5): 231-236 doi: 10.11887/j.cn.202305027SUN Pengyue, LIU Xuhui, MAO Erkun, et al. BRAM anti-irradiation design method for satellite payloads using time-sharing refreshing and location constraint[J]. Journal of National University of Defense Technology, 2023, 45(5): 231-236 doi: 10.11887/j.cn.202305027
|
| [2] |
TRIPPE J M, REED R A, AUSTIN R A, et al. Electron-induced single event upsets in 28 nm and 45 nm bulk SRAMs[J]. IEEE Transactions on Nuclear Science, 2015, 62(6): 2709-2716 doi: 10.1109/TNS.2015.2496967
|
| [3] |
赵元富, 王亮, 岳素格, 等. 纳米级CMOS集成电路的单粒子效应及其加固技术[J]. 电子学报, 2018, 46(10): 2511-2518 doi: 10.3969/j.issn.0372-2112.2018.10.027ZHAO Yuanfu, WANG Liang, YUE Suge, et al. Single event effect and its hardening technique in nano-scale CMOS integrated circuits[J]. Acta Electronica Sinica, 2018, 46(10): 2511-2518 doi: 10.3969/j.issn.0372-2112.2018.10.027
|
| [4] |
WANG Z B, CHEN W, YAO Z B, et al. Proton-induced single-event effects on 28 nm Kintex-7 FPGA[J]. Microelectronics Reliability, 2020, 107: 113594 doi: 10.1016/j.microrel.2020.113594
|
| [5] |
TONFAT J, KASTENSMIDT F L, ARTOLA L, et al. Analyzing the influence of the angles of incidence on SEU and MBU events induced by low LET heavy ions in a 28-nm SRAM-based FPGA[C]//Proceedings of the 2016 16th European Conference on Radiation and Its Effects on Components and Systems. Bremen: IEEE, 2016: 1-6. DOI: 10.1109/RADECS.2016.8093186
|
| [6] |
WIRTHLIN M, LEE D, SWIFT G, et al. A method and case study on identifying physically adjacent multiple-cell upsets using 28-nm, interleaved and SECDED-protected arrays[J]. IEEE Transactions on Nuclear Science, 2014, 61(6): 3080-3087 doi: 10.1109/TNS.2014.2366913
|
| [7] |
PÉREZ-CELIS A, WIRTHLIN M J. Statistical method to extract radiation-induced multiple-cell upsets in SRAM-based FPGAs[J]. IEEE Transactions on Nuclear Science, 2020, 67(1): 50-56 doi: 10.1109/TNS.2019.2955006
|
| [8] |
LEE D S, WIRTHLIN M, SWIFT G, et al. Single-event characterization of the 28 nm Xilinx kintex-7 field-programmable gate array under heavy ion irradiation[C]//Proceedings of 2014 IEEE Radiation Effects Data Workshop. Paris: IEEE, 2014: 1-5. DOI: 10.1109/REDW.2014.7004595
|
| [9] |
封国强, 姜昱光, 朱翔, 等. 脉冲激光和重离子辐照FPGA产生的多位翻转效应的比较[J]. 原子能科学技术, 2014, 48(S1): 732-736FENG Guoqiang, JIANG Yuguang, ZHU Xiang, et al. Comparison of multi-bit upset in FPGA induced by pulsed laser and heavy ions[J]. Atomic Energy Science and Technology, 2014, 48(S1): 732-736
|
| [10] |
XILINX. UG474(v1.8), 7 Series FPGAs Configurable Logic Block[EB/OL]. 15-16. [2016-09-27]. https://docs.xilinx.com/v/u/en-US/ug474_7Series_CLB
|
| [11] |
XILINX. UG470(v1.17), 7 Series FPGAs Configuration[EB/OL]. 100-100. [2023-12-05]. https://docs.xilinx.com/v/u/en-US/ug470_7Series_Config
|
| [12] |
上官士鹏, 朱翔, 陈睿, 等. Flash芯片电流“尖峰”现象的脉冲激光试验[J]. 北京航空航天大学学报, 2021, 47(5): 961-966 doi: 10.13700/j.bh.1001-5965.2020.0082SHANGGUAN Shipeng, ZHU Xiang, CHEN Rui, et al. Experimental results of high current spike in Flash chip by pulsed laser[J]. Journal of Beijing University of Aeronautics and Astronautics, 2021, 47(5): 961-966 doi: 10.13700/j.bh.1001-5965.2020.0082
|
| [13] |
MA Y Q, HAN J W, SHANGGUAN S P, et al. SEE characteristics of COTS devices by 1064 nm pulsed laser backside testing[C]//Proceedings of 2018 IEEE Radiation Effects Data Workshop. Waikoloa: IEEE, 2018: 1-4. DOI: 10.1109/NSREC.2018.8584271
|
| [14] |
HUANG Jianguo, HAN Jianwei. Calculation of LET in SEE simulation by pulsed laser[J]. Science in China (Series G), 2005, 48 (1): 113-121
|
| [15] |
李赛, 陈睿, 韩建伟, 等. 脉冲激光诱发65nm体硅CMOS加固触发器链的单粒子翻转敏感度研究[J]. 航天器环境工程, 2021, 38(1): 55-62 doi: 10.12126/see.2021.01.009LI Sai, CHEN Rui, HAN Jianwei, et al. Sensibility of single event upset of hardened D flip-flop chain in 65 nm bulk si-licon CMOS irradiated by pulsed laser[J]. Spacecraft Environment Engineering, 2021, 38(1): 55-62 doi: 10.12126/see.2021.01.009
|
| [16] |
XILINX, UG473(v1.14), 7 Series FPGAs Memory Resources[EB/OL]. 33-33. [2019-07-03]. https://docs.xilinx.com/v/u/en-US/ug473_7Series_Memory_Resources
|





 薛国凤 女, 1984年6月出生于陕西省西安市, 现为中国科学院国家空间科学中心高级工程师, 主要研究方向为空间综合电子技术. E-mail:
薛国凤 女, 1984年6月出生于陕西省西安市, 现为中国科学院国家空间科学中心高级工程师, 主要研究方向为空间综合电子技术. E-mail: 
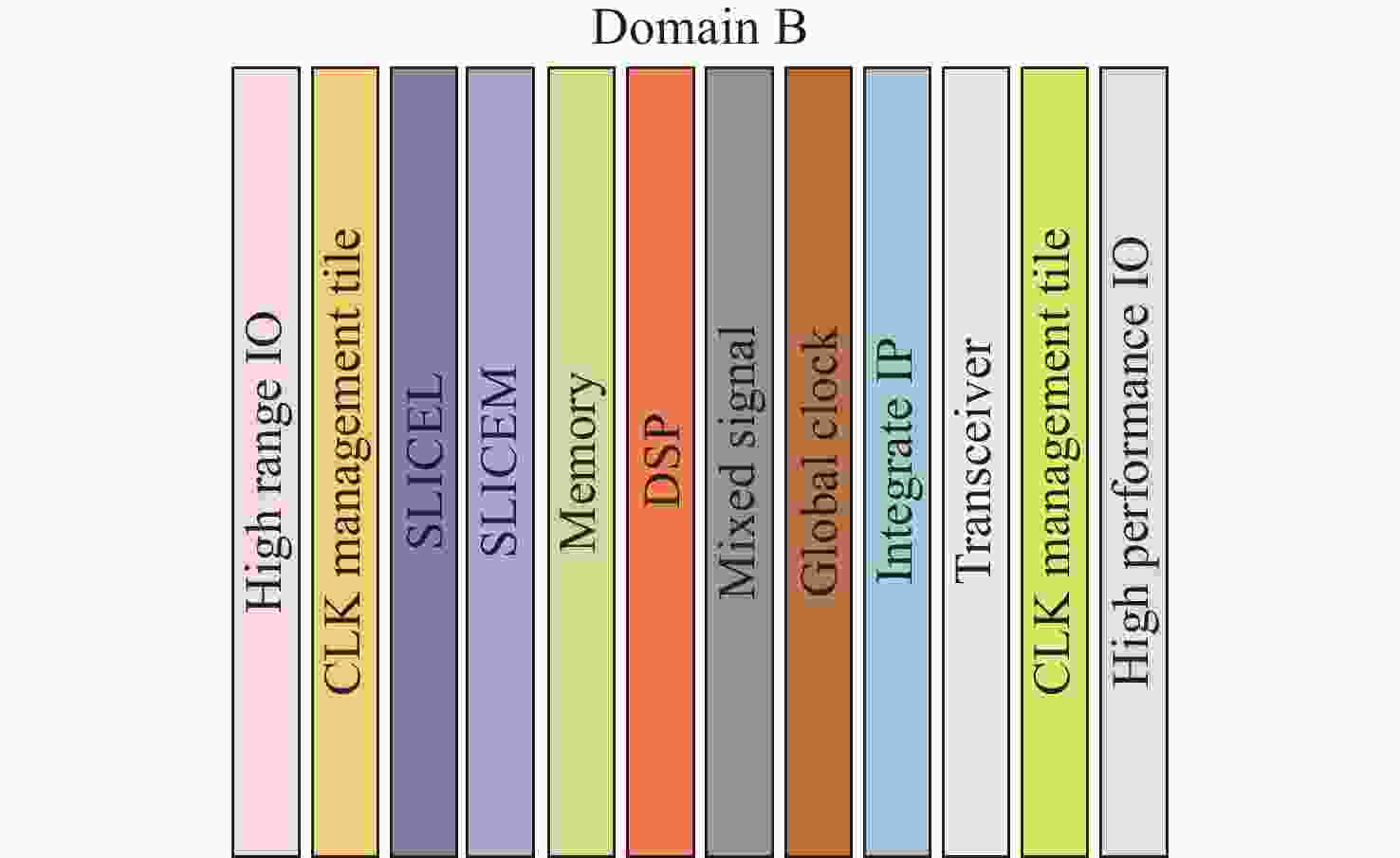
 下载:
下载: